中古 VACUUM SYSTEMS TECHNOLOGY / VST TFSP-840 #293602592 を販売中
URL がコピーされました!
タップしてズーム
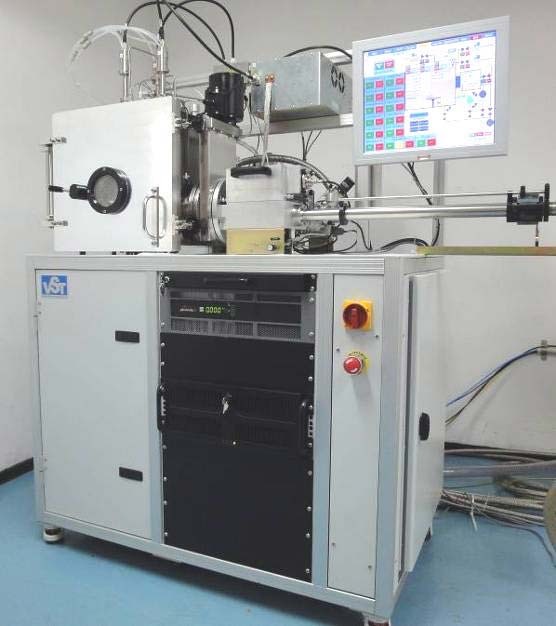







ID: 293602592
Sputtering system
Ultimate vacuum pressure: 3x10^-7 Torr
Base pressure: 1x10^5 Torr
Pirani gauge, 100 to 1x10^-5 Torr
Maximum allowable leak rate: <1x10^-9 mbar L/sec (Helium)
Vacuum pumping system
PLC Controlled power switching boxes
DC Blocked filters
Substrate holder
PLC / PC Computer control
Targets:
Titanium Tungsten: (Ti) 10 (W) 90 %
Copper (Cu)
Silicon Nitride (Si3N4)
Sputtering mode:
DC / DC Pulsed
RF
Combination of RF and DC
Chamber:
High grade stainless steel, water cooled, SS 304L
3-Ports
RF Shielded view port, 4"
Pumping port
Load lock chamber:
Loading sample holder, Up to 6"
EDWARDS nXDS10 Dry pump:
Pressure: 8x10^-3 Torr
Nominal pumping speed: 10 m³/hrs
EDWARDS EXT75iDX Turbo molecular pump:
Pumping speed: 61 L/sec
Compression ratio N2: >1x10^11
Ultimate pressure: 5x10^-8 mbar
Nominal rotational speed: 90,000 rpm
Air cooling
Sputtering sources:
Source dimension: MAK, 4"
Mounting feedthrough: Quick coupler, 0.75"
Target specifications:
Target diameter: 4"
Target mounting: Magnetic
Magnetic materials
Magnet design:
Type: Nd/Fe B
Configuration: Balanced/Unbalanced
Operation specifications:
DC Max power: 3000W
RF Max power: 1200W
Cathode voltage (Volts): 200-1000V
Discharge current (Max amps): 7 amp
Cooling water:
Flow rate 1.0 gpm
Vacuum interlock
High voltage switch
Chamber switch
Load-lock switch
Dry air pressure switch
Water flow switches
Substrate temperature
Emergency stop
Electrical overload protection
Gas line:
Gas / MFC
Ar / 1-100 SCCM
N2 / 1-50 SCCM
O2 / 1 – 50 SCCM
Maximum beam current:
25 to 35% of discharge current
280mA (Ar @ 1A)
350mA (O2 @ 1A)
Beam energy (Mean): 50 to 180eV (~60% of Anode voltage set point)
Max discharge power: 300W (200W Continuous)
Discharge voltage range:
Ar: 50 to 300V
O2: 100 to 300V
Discharge current range: 0.2 to 1A (Mark I + Ion Source Controller)
Max operating pressure: 1 x 10^-3 Torr (0.13Pa)
Gas use: Inert Gases, O2, N2 and other reactive gases
Typical gas flow range: 2-20sccm
Ion beam neutralization: Filament cathode
Ion beam size (at opening): 1.1 in (28mm) Diameter
MFC 20 sccm
Power supply:
RF Power supply: 13.56 MHz, 600 W
DC Power supply: 1500 W.
真空システムテクノロジー/VST TFSP-840は、堅牢で一貫したスパッタリング性能を提供する汎用性の高いスパッタリング装置です。このシステムには複数のチャンバー構成が装備されており、さまざまなツールやアクセサリに対応できます。薄型・フレキシブルな基板加工が可能で、様々な材料への信頼性と再現性に優れています。VST TFSP-840は、絶縁ローディングチャンバーと独立したプロセスチャンバーを備えた最先端の2つのチャンバ設計を利用しています。ローディング部屋は粒子の汚染を減らし、速く、容易なサンプルのローディングを可能にするように設計されています。各チャンバーには2インチラフィングポンプが装備されており、安定した低圧環境を作り出し、効率的な動作を保証します。ローディングチャンバーは、空中汚染物質を最小限に抑え、スムーズな動作を確保するために、ロードロックドアを使用しています。プロセスチャンバーには、VACUUM SYSTEMS TECHNOLOGY TFSP-840に8つのカソードと駆動基板回転機構が装備されています。各陰極は独自に電源設定とスパッタリングターゲットを調整できます。高性能な基板回転機構により、基板全体に均一で均一な成膜が可能です。トップマウントされたスパッターガンにより、機械を簡単にコンテナ化して、広域サンプルの現場処理を行うことができます。TSFSP-840には、改造基板ホルダー、外部基板加熱、ローラー搬送ツール、船上リフト/ダイレクトアクセスアーム、安全で中断のない動作を保証する安全ロックなど、さまざまなアクセサリーが装備されています。加えられた特徴はTSFSP-840を産業適用のための理想的な候補にします。その豊富な機能により、TFSFP-840は一貫した反復可能な結果を提供し、さまざまな基板上で信頼性の高い薄膜蒸着を保証します。このアセットは、正確なプロセス制御と確実に再現可能なパフォーマンスを提供するため、高スループットアプリケーションに適しています。さらに、ユーザーフレンドリーなタッチスクリーンインターフェースにより、シンプルで便利な操作が可能です。
まだレビューはありません