中古 MRC 822 #9039130 を販売中
URL がコピーされました!
タップしてズーム






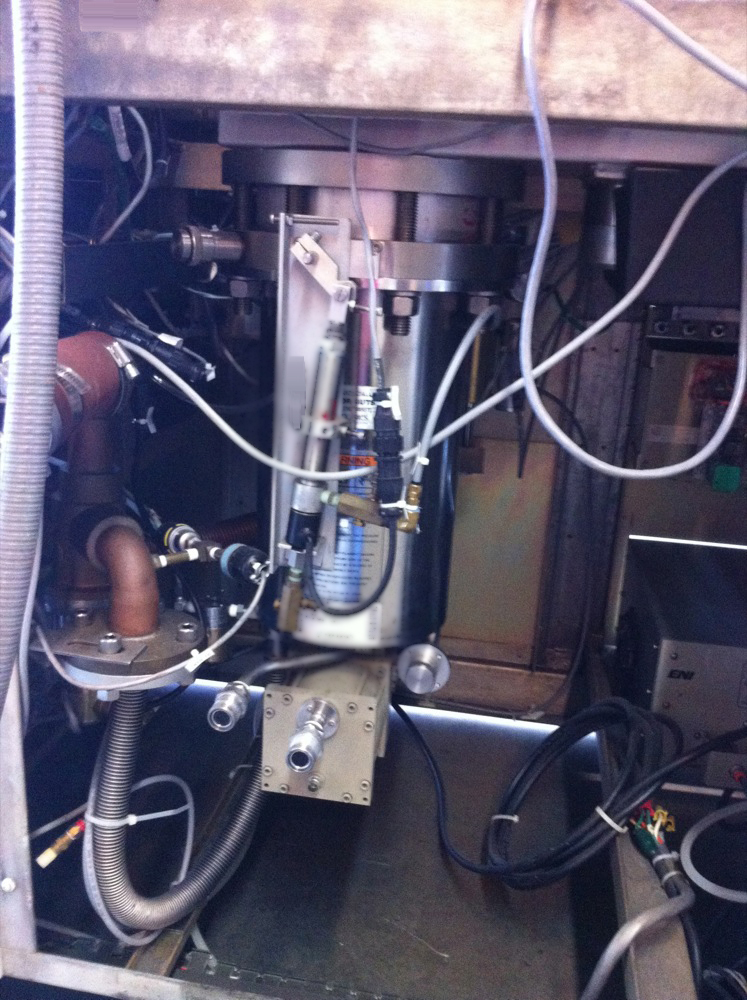

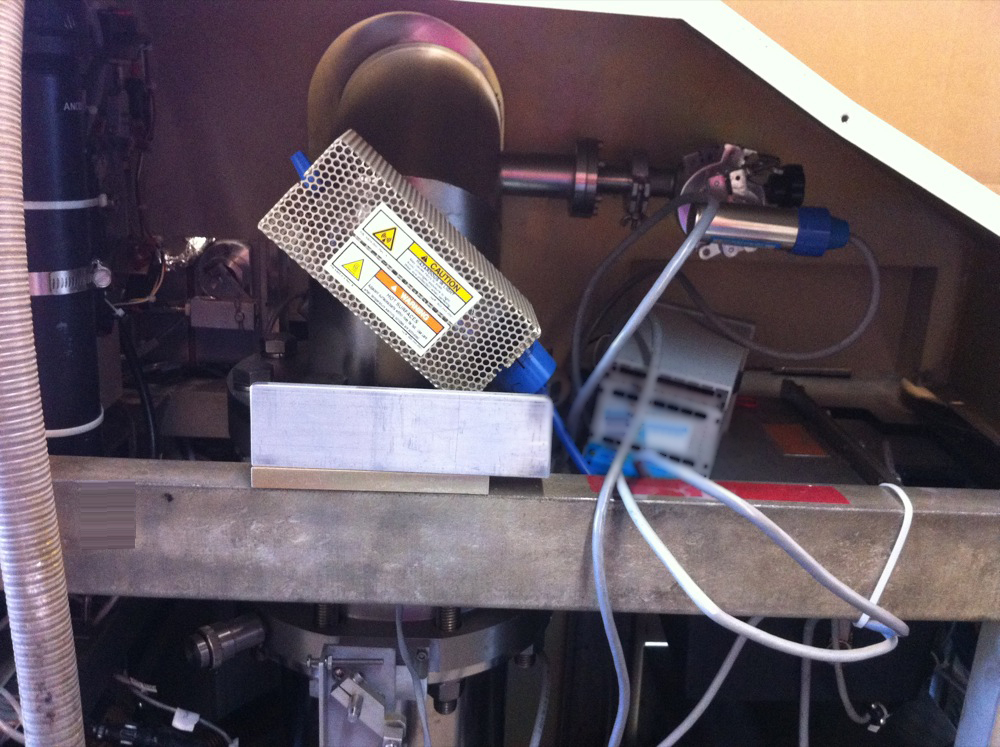





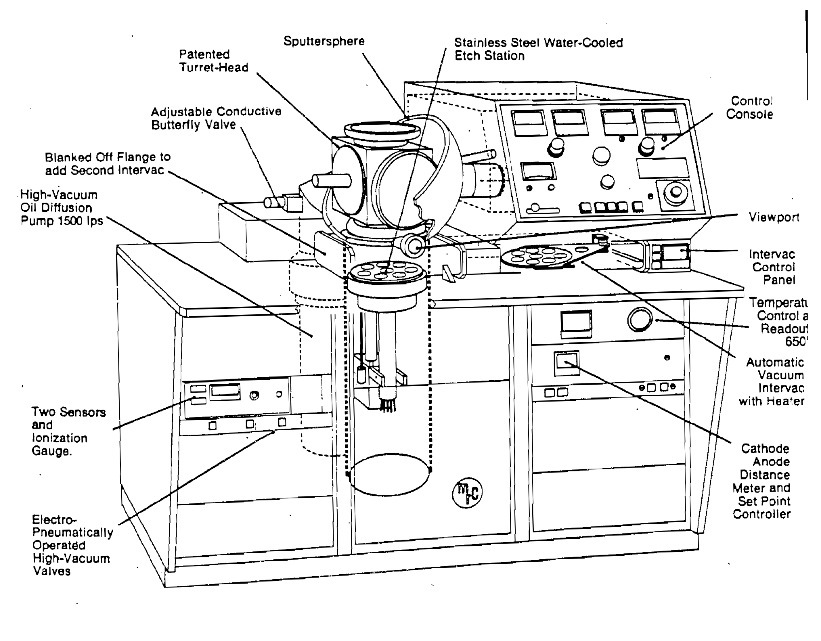



ID: 9039130
Sputterspheres
With load lock
Includes:
(3) Diode targets, 8"
Spherical chamber, 19"
Sputters up to (3) materials without breaking the vacuum
CTI 8 Cryo pump with SC compressor
LEYBOLD D-60 Mechanical pump
ENI OEM-6 RF Generator, 1.25 kW
Sputter etch
GP-280 IG controller
VARIAN TC controller
Load locked system
Pallet, 8"
Complete set of manuals
Eye-level control console:
Forward and reflected power meters
Two peak-to-peak meters
Remote power control
Multi-range sputter timer
Sputter button
Pirani gauge
Modes of operation:
Diode deposition: RF Diode, RF Bias
Magnetron deposition: DC and RF
Reactive sputtering
Sputter etching
RF System:
Voltage stabilization
RF Matching network
Auto tuning
Vacuum
Dual loadlock: two pallet mode, three pallet mode
Semi-automatic operation speeds
DC Magnetron power supply: Model: S3016
80-100 psi air, 60-90 psi water, 3 GPM
208 V, 50 Amp, 50/60 Hz, 3 Phase.
MRC 822は、材料を処理するための高電流イオン源を使用した高エネルギーイオンビームスパッタ装置です。この高度なスパッタリング技術は、さまざまな基板に薄膜を堆積させるために使用されます。822システムはスパッタパラメータのプロセス制御そして監視を可能にするユーザーフレンドリーな制御インターフェイスが付いているコンピュータ制御機械です。MRC 822ユニットは、真空チャンバーとイオンビーム源の両方を使用して基板を処理します。真空チャンバーはステンレス鋼で構成されており、通常10〜5〜10〜6 Torrの範囲で低真空レベルを維持するように設計されています。チャンバー内部には、安定した圧力でターゲットを維持するために内部真空機も使用されています。ファラデーケージがターゲットを囲み、ツールコンポーネントの電気絶縁とシールドを提供します。イオンビーム源は高出力のリニア加速器で構成されており、ビームエネルギーや粒子サイズなどのスパッティングパラメータを制御するための高度な制御が可能です。加速器は、100-200 keVの範囲で粒子エネルギーを生成し、粒子サイズは1-10 nmです。イオンビーム源は電子銃を収容することができ、可能なビーム形状の広い範囲を可能にします。さらに、イオンソースはエッチング用途にも使用でき、特定のターゲットを選択的にエッチングできます。822はまた、非導電基板への膜の堆積を可能にするin-situ基板バイアス機能を備えています。この機能は、MEMSなどの薄膜コーティング用途など、浸透深度や材料層を必要とするフィルムに最適です。このアセットは超微細なフィルム蒸着が可能で、低エネルギーイオン蒸着プロセスで2〜3nmの解像度を実現できます。全体として、MRC 822は強力で汎用性の高い高エネルギースパッタリングモデルです。コンピューター制御のユーザーフレンドリーなインターフェイスにより、正確で信頼性の高いスパッタ処理パラメータを簡単に入力できます。ステップバイステップのプロセス制御とモニタリングにより、ほぼすべての基板上で正確な成膜とエッチングを行うことができます。高出力リニアアクセラレータと電子銃の組み合わせにより、2〜3 nmの解像度でフィルムを堆積させることができます。
まだレビューはありません








