中古 JEOL JEM 2010F #293585832 を販売中
URL がコピーされました!
タップしてズーム
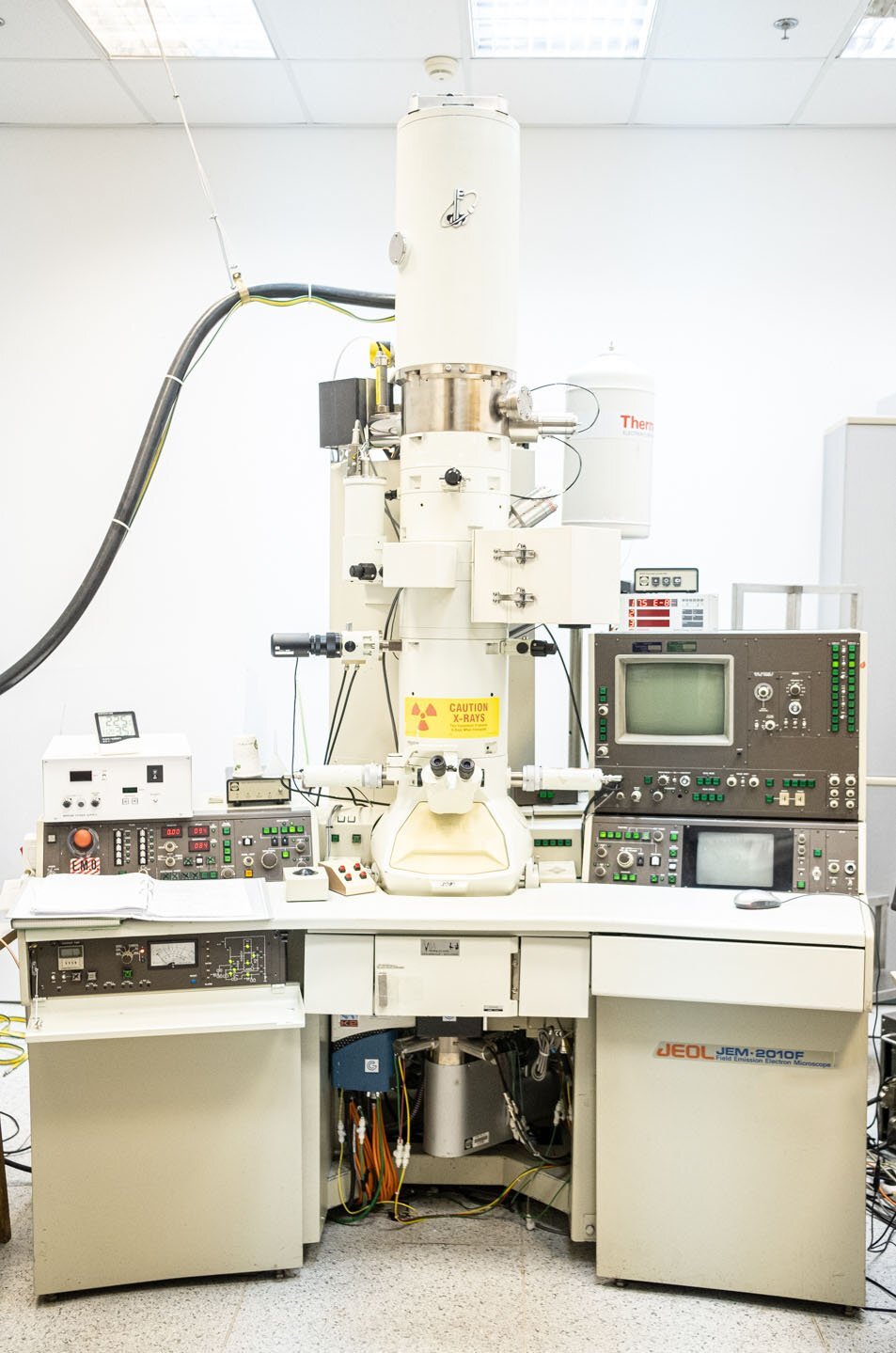





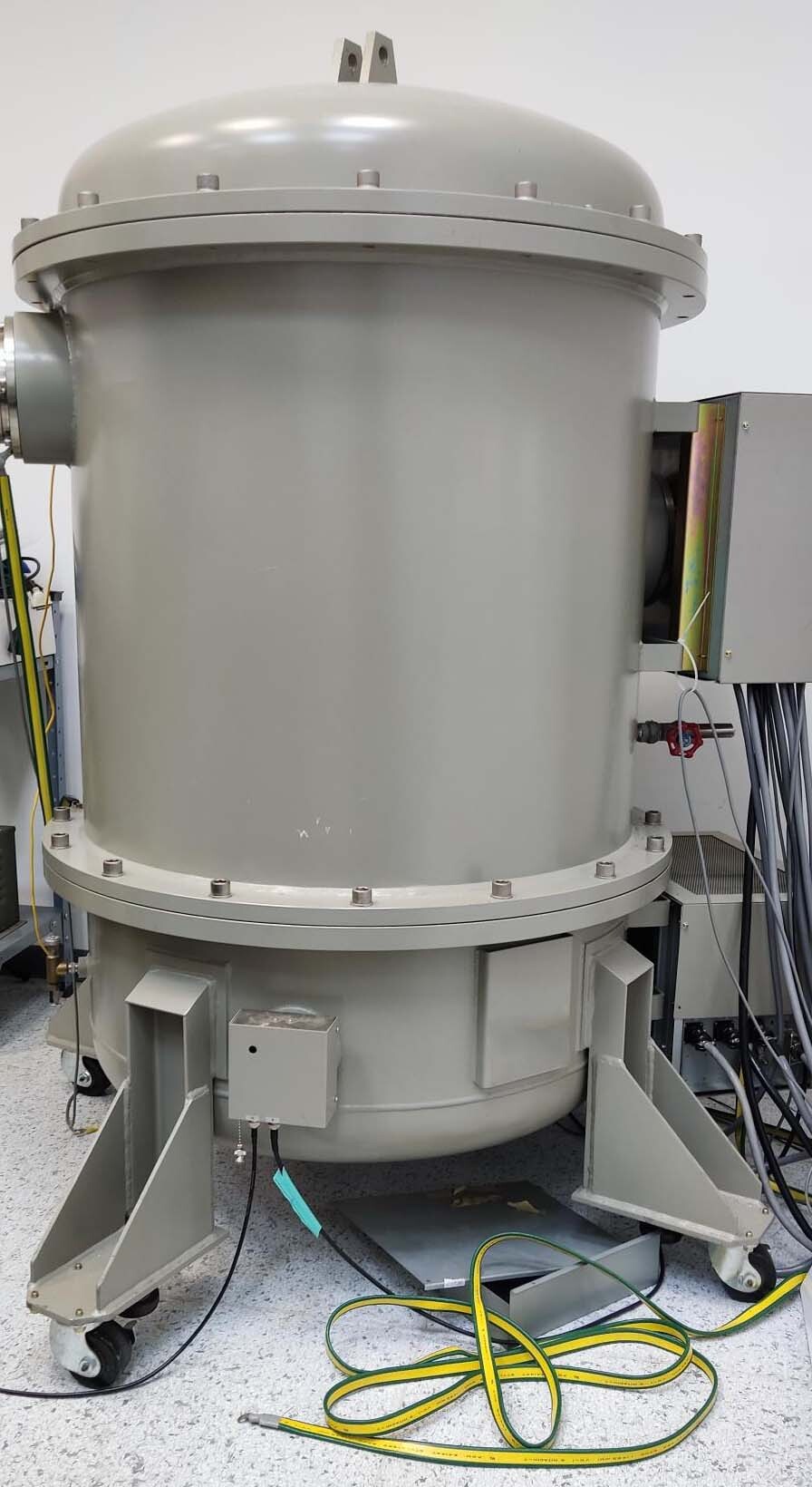









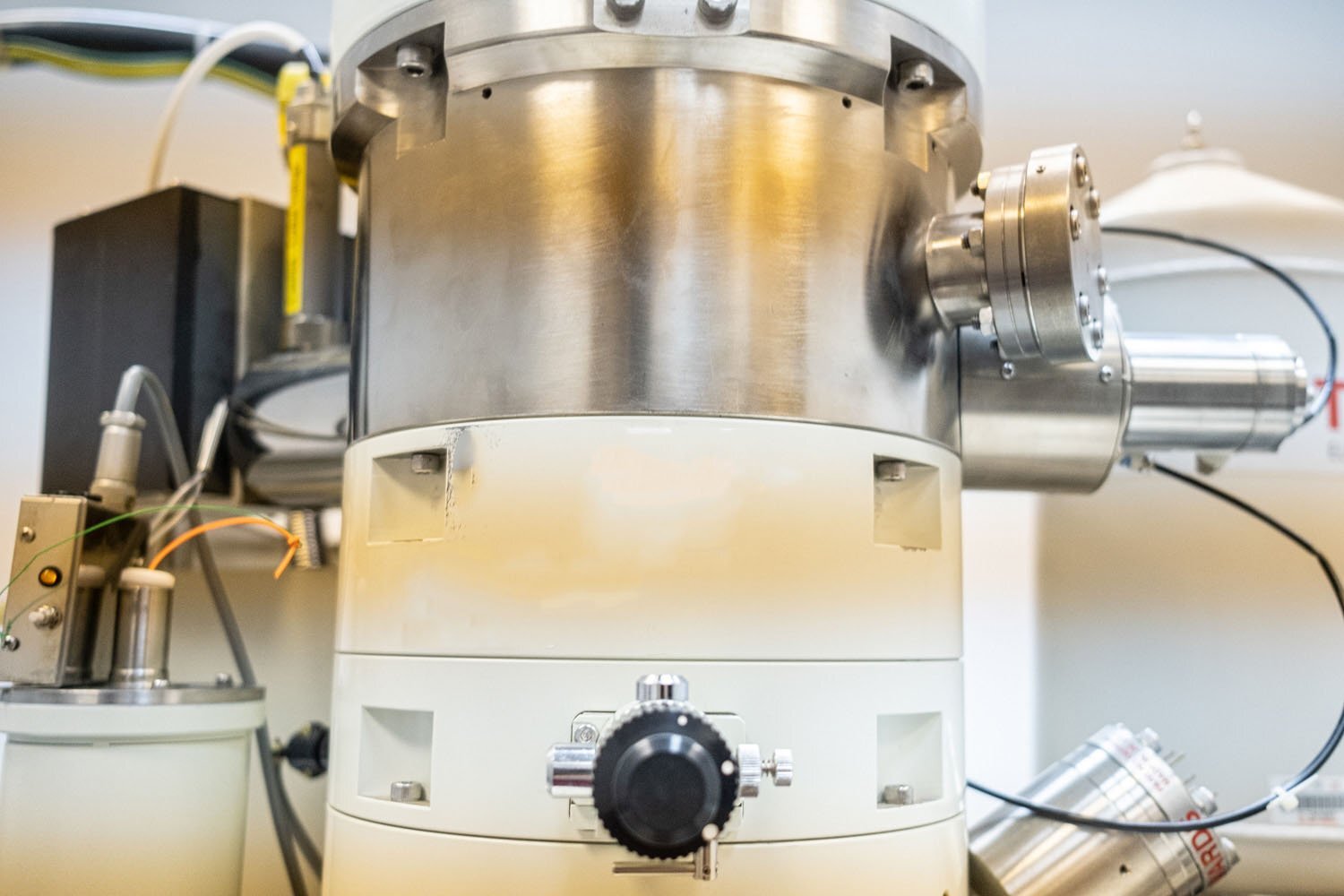































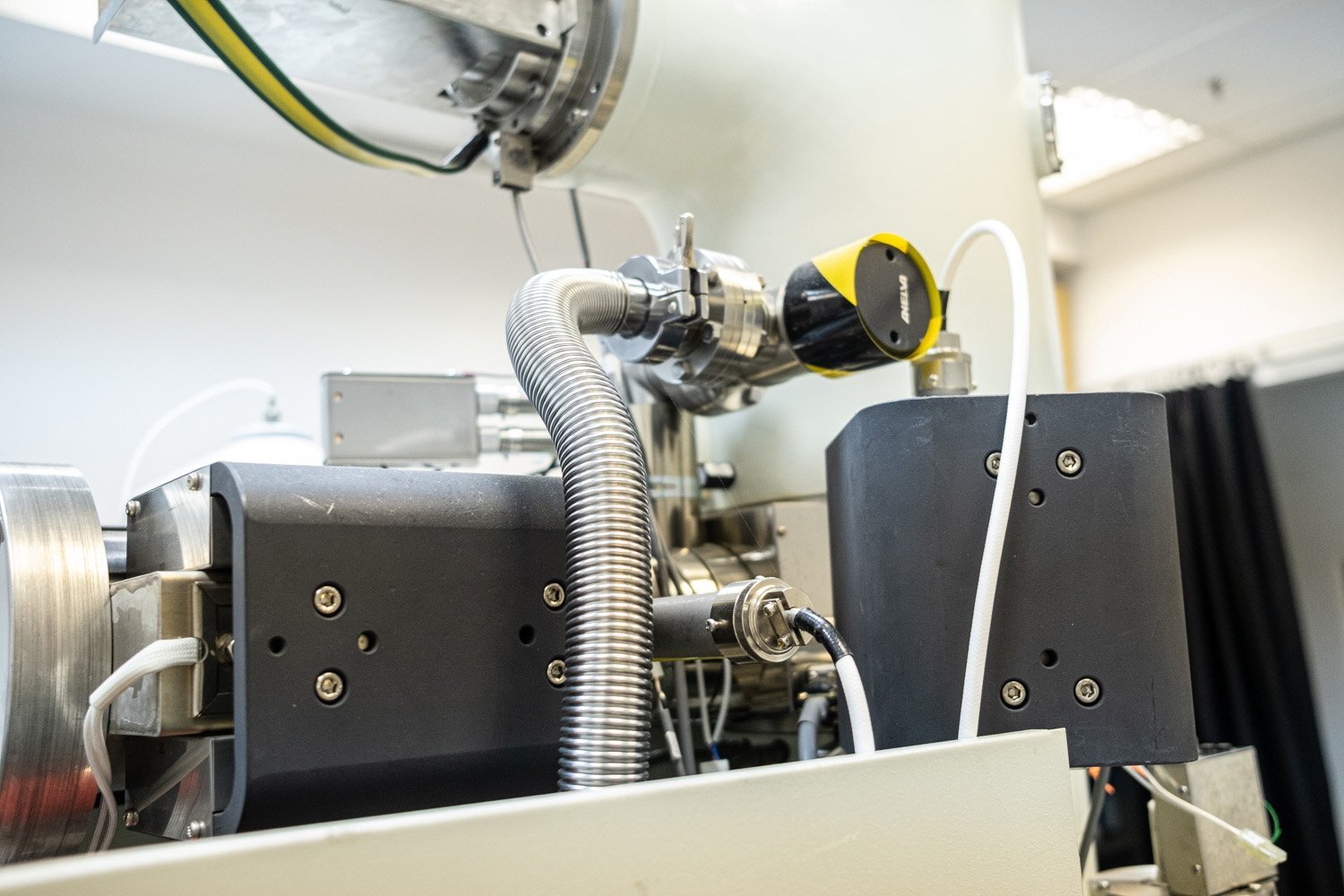





















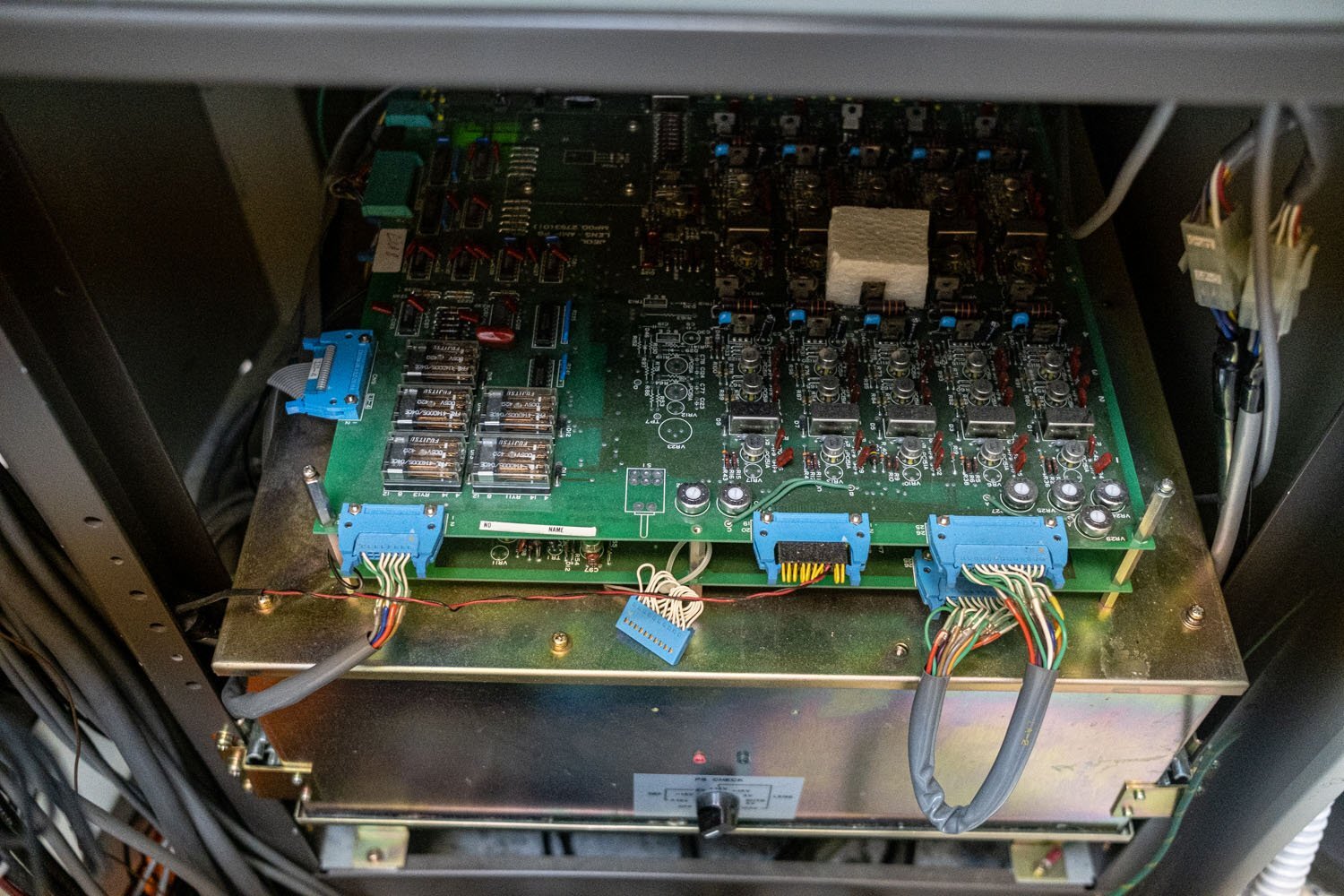

















































ID: 293585832
Scanning Transmission Electron Microscope (STEM)
UHR Objective pole
Spherical aberration coefficient: 0.5 mm
Point-point resolution: 0.19 nm
Information limit: 0.1 nm
Energy resolution: 133 eV
SiLi detector
Resolution imaging
Collection angle: 0.13 Sterad
Take off angle: 20°
Phase resolution: 100 rad
JEOL Bi-Prism electron holographic measurements
Medium and low magnifications
EDS
EELS
K2
Power supply: 80 kV-200 kV.
JEOL JEM 2010Fは、研究者、技術者、業界の専門家にサブミクロン、フィーチャーレベル分析に必要なツールを提供する高度な走査型電子顕微鏡(SEM)です。JEOL JEM-2010Fは、様々な材料分析、ミクロンレベルの観測、欠陥解析、自動運転に最適化されています。JEM 2010Fは、乾式と液状の両方の材料を含む、小さなサンプルの非常に高解像度のイメージングを提供しています。1ミクロンの開口部から200ミクロンの範囲まで、さまざまなサンプルサイズを分析することができます。JEM-2010Fによって提供される広い被写界深度は、最大150,000Xの高倍率で詳細な画像をキャプチャすることができます。高解像度と被写界深度を組み合わせることで、表面や表面下のインクルージョン、腐食、粒界、結晶欠陥などの高コントラスト特性を検出することができます。JEOL JEM 2010Fは、高度なソフトウェア技術によって可能になった自動顕微鏡機能も提供しています。JEOL JEM-2010Fの自動化された機能は、解析の複数の段階からの画像取得を組み合わせたり、複数のサンプルを同時に作業したり、さまざまなツールを使用してスキャン処理を制御するなど、多くの便利なオプションをユーザーに提供します。JEM 2010Fには、さまざまなサンプルおよび解析タイプの高度な信号解析オプションも含まれています。JEM-2010Fで利用可能な信号解析ツールは、信号パターン、色調変化、およびヒートマップを分析して、極めて小さなスケールで材料の微細構造の変化を検出するために使用できます。JEOL JEM 2010Fの性能は、ICS (Intelligent Control Equipment)によってさらに向上しています。ICSは、システムが動作するたびに正しく動作し、イメージングが最適化されることを保証するために、人工知能を組み込んでいます。インテリジェントユニットはまた、完全に自動化された測定シナリオを可能にし、より高速なイメージング、より高いスループット、より一貫した結果をユーザーに提供します。結論として、JEOL JEM-2010Fは、詳細レベルのリアルタイムイメージングを可能にするさまざまな機能を備えた高度なSEMです。自動化されたイメージングおよび信号解析機能は、高品質の結果を保証するためのさまざまな強力なツールを提供し、インテリジェントコントロールマシンはすべての画像の信頼性と精度を提供します。
まだレビューはありません