中古 KLA / TENCOR P15 #293653975 を販売中
URL がコピーされました!
タップしてズーム


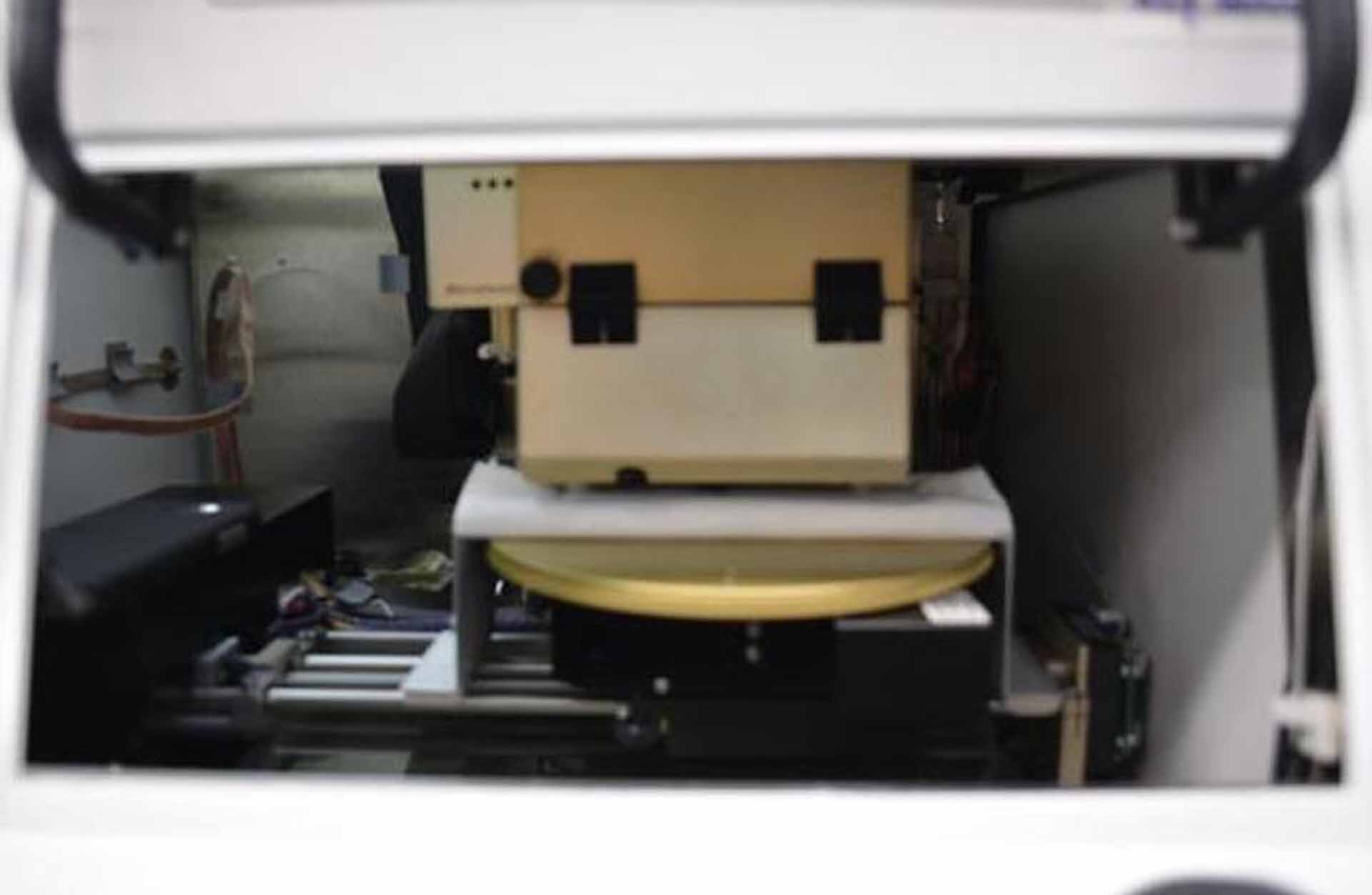

ID: 293653975
ウェーハサイズ: 8"
Surface profiler, 8"
Upgraded from P10
Stylus
Wafer load profilometer
Scan length: 200 mm
Microhead II LF:
Maximum step height: ~131 µm
Stylus force: 0.5-50 mg
Step height: 6.5 µm, Resolution: <0.05 å
Step height: 26 µm, Resolution <2.0 å
Step height: 130 µm, Resolution <10.0 å
Top and side view optics
2D Stress analysis
Stress plate
Micro-roughness: 0.5 å (0.002 Minimum)
Vertical features ranging: 100 å (131 µm)
Vertical resolution: 0.05, 2, or 10 å
PC
LCD Monitor
USB Ports
Operating system: Windows XP.
KLA/TENCOR P15 Wafer Testing and Metrology Equipmentは、半導体ウェーハ上で異常や汚染などの欠陥を識別し、特徴付けるために設計された高精度ツールです。これは、サブ50nmデバイスの製造を含む、さまざまなリソグラフィおよび計測プロセスに適しています。このシステムには2つの広い視野光学ヘッドが装備されており、高い空間分解能で完全な視野を提供します。このユニットには、迅速かつ正確な欠陥検出と分類を可能にする高度なソフトウェアアルゴリズムが含まれています。KLA P-15には統合計測機能も搭載されており、ウェーハ表面全体にわたる重要寸法、線幅、オーバーレイを自動測定できます。TENCOR P 15には、デュアルイメージキャプチャモジュール(DICM)が搭載されています。DICMは、欠陥解析のための重要な高解像度光学イメージングを提供し、ウェーハ上の欠陥領域、形状、位置の自動解析を可能にします。KLA P 15には高度なスマートカートリッジ(ASC)も装備されており、インテリジェントなスキャン機能を提供します。ASCにより、ウェーハ表面全体を徹底的かつ体系的にスキャンできます。このツールには、ISO 2645準拠のスパースおよび高密度の欠陥検出を含む高度なウェーハ表面欠陥検出アルゴリズムが組み込まれています。KLA/TENCOR P-15には、強力な画像比較および欠陥分類ツールを提供する結果解析モジュールが含まれています。Results Analysisモジュールは、欠陥を自動的に検出および分類し、重要な寸法、線幅、およびオーバーレイを測定できます。P-15は、自動レビュープロセス用に構成することができ、複数のウェーハにわたる欠陥データの包括的かつ包括的な分析を可能にします。この資産には、すべての欠陥関連アクティビティの監査証跡を提供する広範なレポート機能も含まれています。TENCOR P-15ウェーハテストおよび計測モデルは、半導体ウェーハの検出、分類、測定に関する包括的なソリューションを提供します。デュアルイメージキャプチャモジュール、モジュール式の高解像度イメージング装置、高度なソフトウェアアルゴリズムにより、欠陥とその関連特性を迅速かつ正確かつ徹底的に分析できます。KLA/TENCOR P 15は、標準デバイスとサブ50nmデバイスの両方の製造に適しており、すべての欠陥関連活動の監査証跡を提供します。
まだレビューはありません

