中古 VON ARDENNE WM70H / C #9172921 を販売中
URL がコピーされました!
タップしてズーム




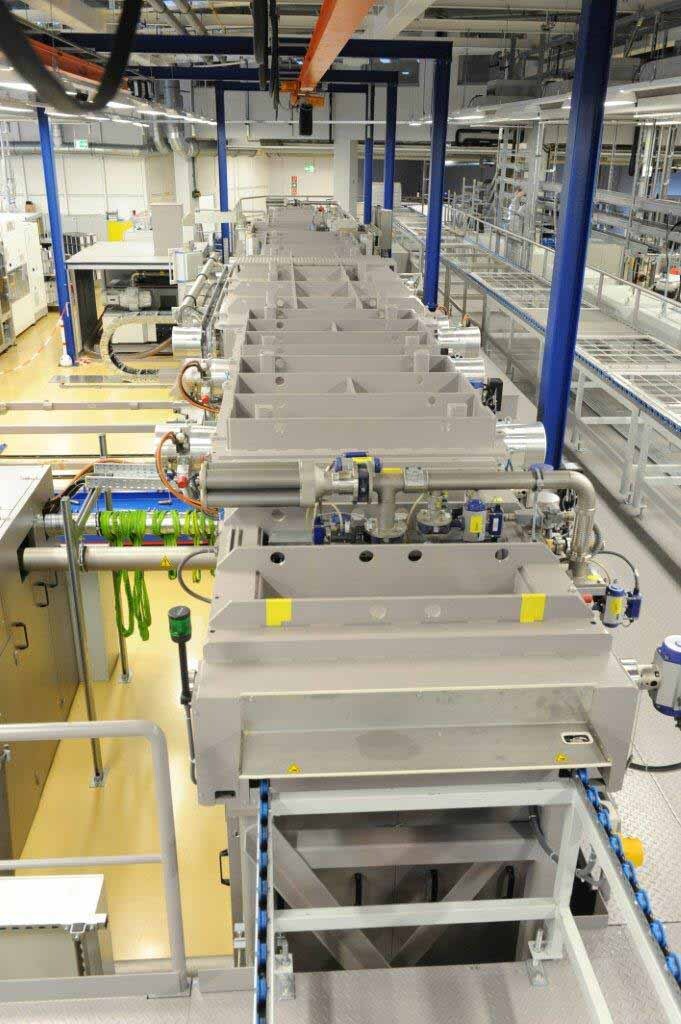



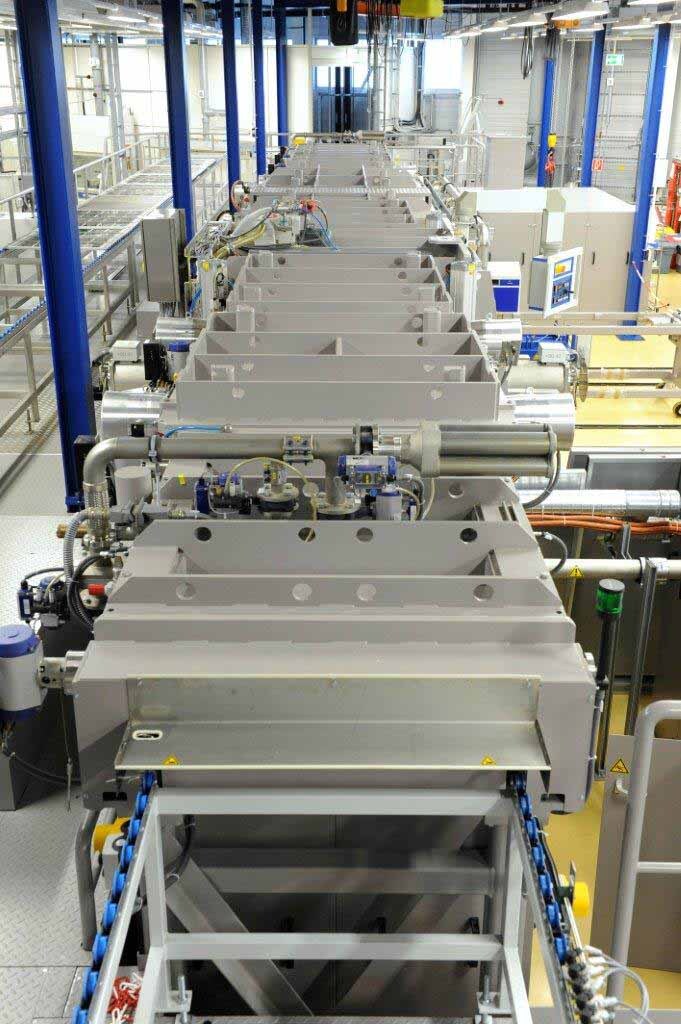



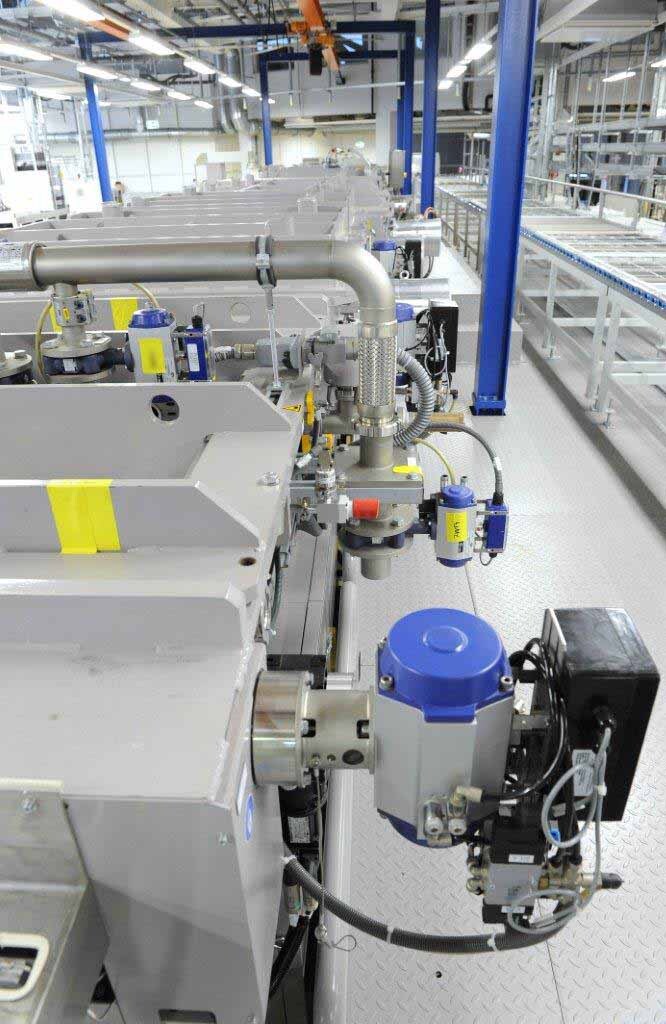

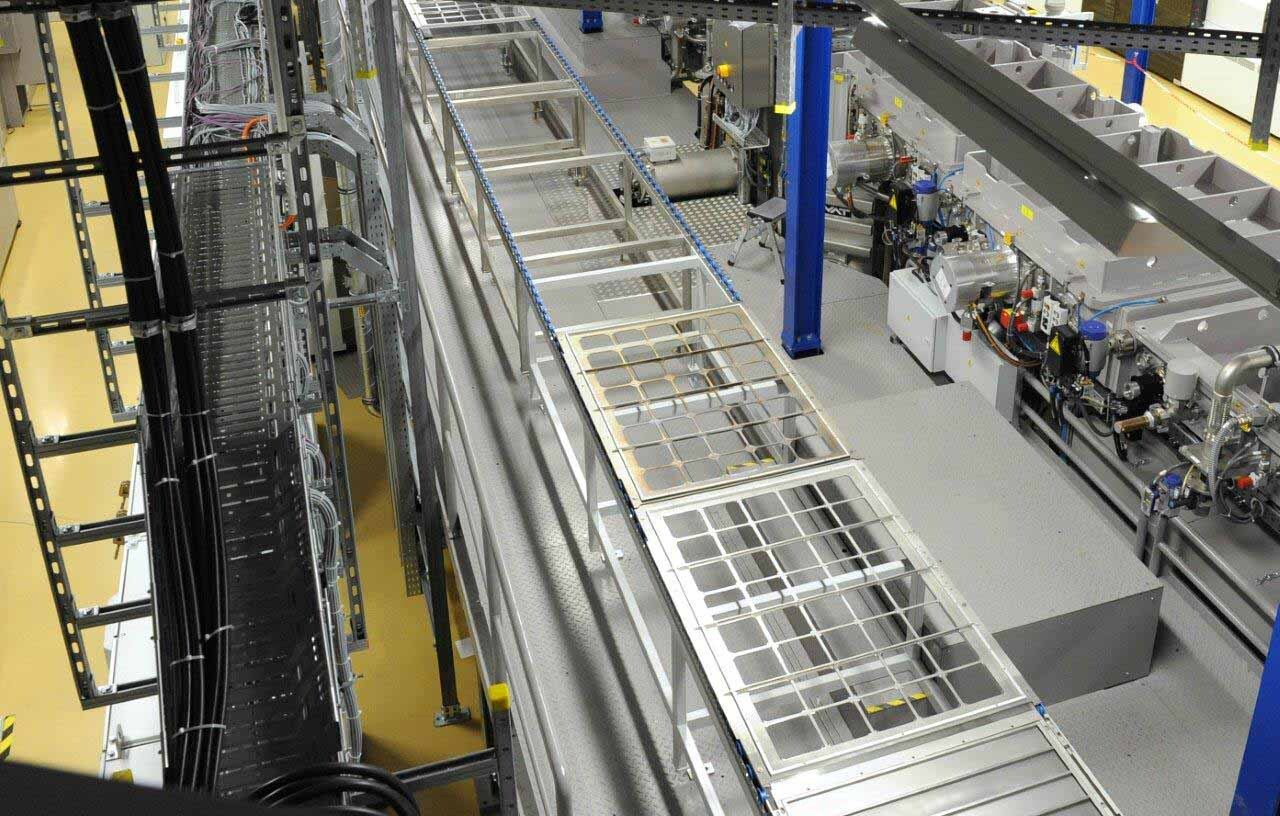



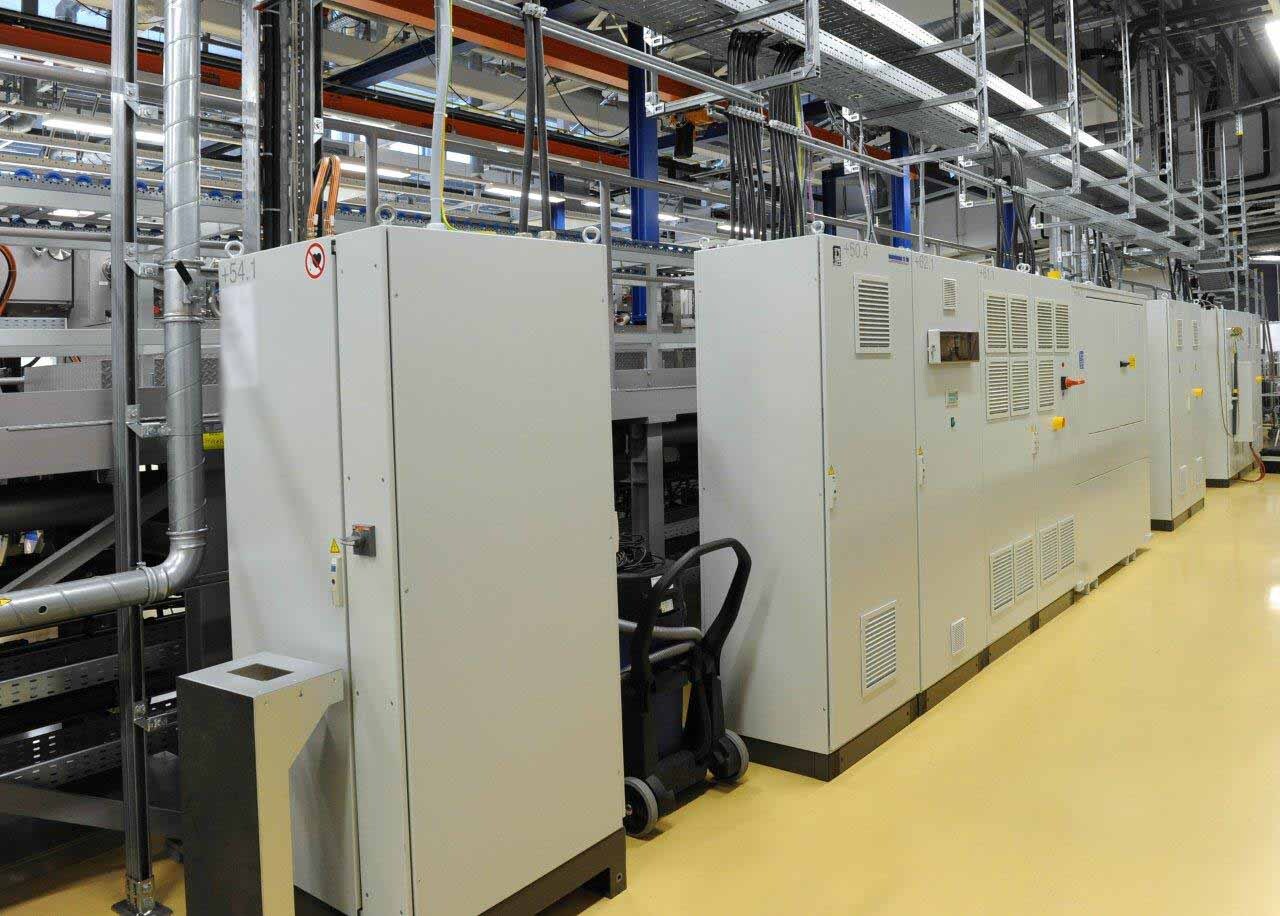







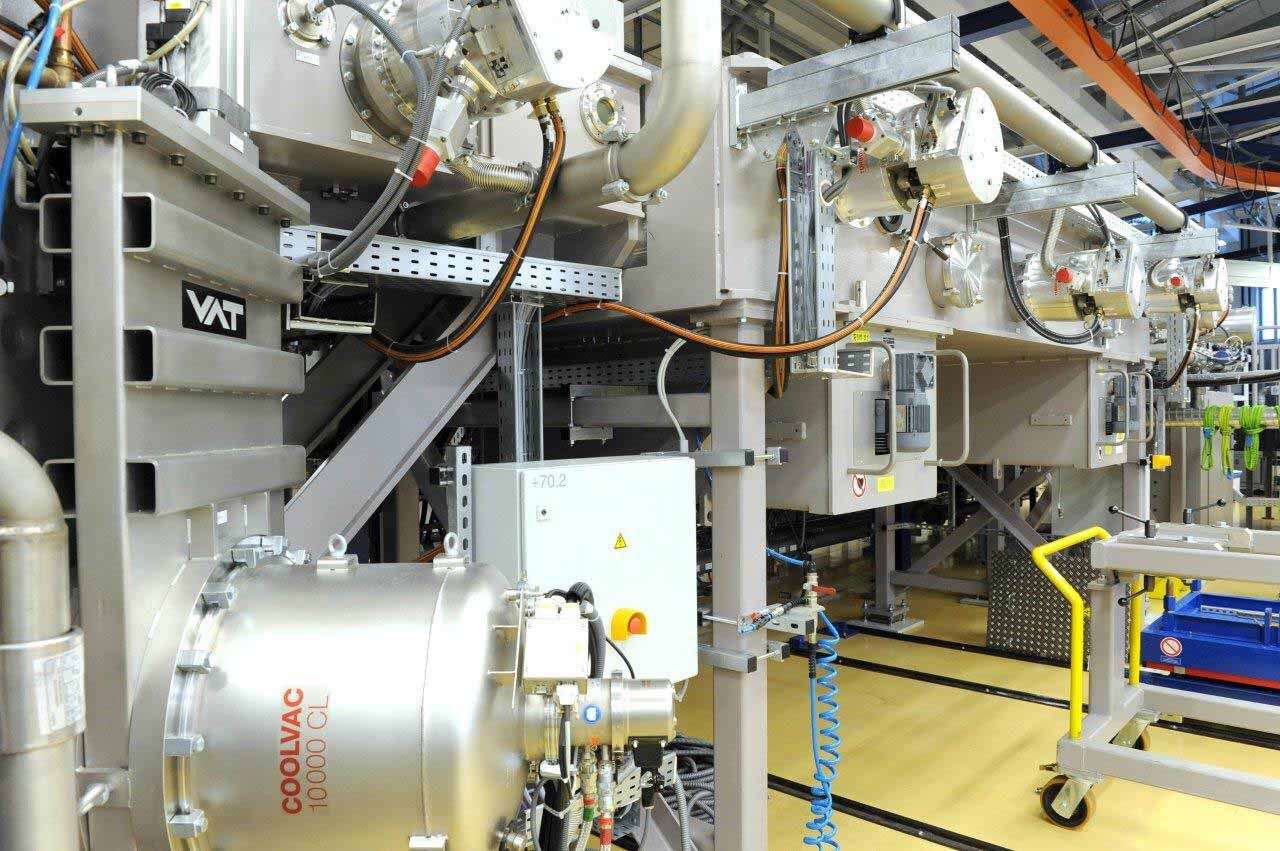





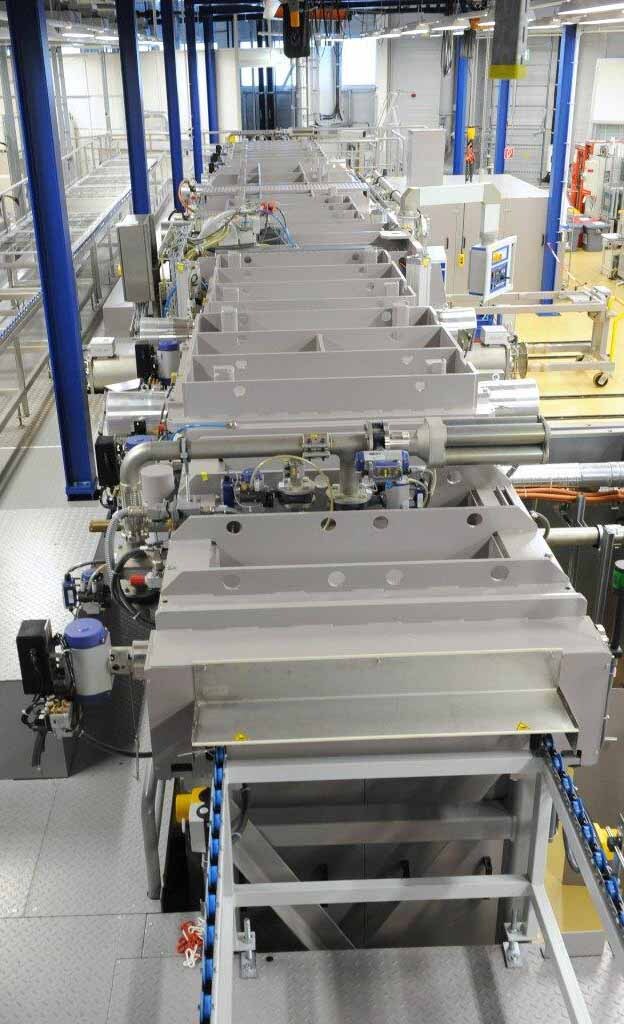













ID: 9172921
High end coating line
Wafer metallizer
In-line complete system for coating wafers
Back coating of silicon wafers with an aluminum layer
Coating of nickel, silver and aluminum by electron beam evaporation
(35) Cells can be coated per tray
Productivity:
4,000 Wafers (5") per hour
2,600 Wafers (6") per hour
Cycle time: 50s
Technical parameters:
System dimensions:
Length: 19 m
Area: 20 x 7 m
Height: ~3 m
Drive:
Carrier speed max: 5 m/min
Carrier speed during vapor deposition: 1.5 - 2.0 m/min
Substrate temperature:
Max. temperature: 300°C / 572°F
Carrier dimensions:
Length: ~1,450 mm
Width: 925 mm
(60) Wafers (5") per carrier
(40) Wafers (6") per carrier
Ambient conditions:
Ambient temperature:
+15 to 35 °C
+59 to 95 °F
Relative humidity at 30°C / 86°F: < 70 %
Dust: < 10 mg/m3
Sluice chambers C1 and C7
Buffer chambers C2 and C6
Transfer chamber C5
Process chamber C4:
EB Chamber C3 / C4.1 / C4.2
Sputter chambers
(5) Sections (C4.3 to C4.7)
Vacuum
Working pressure:
C2 - Buffer chamber 2 to 5 x 10-3 mbar
C4.1 - EB chamber 5 to 9 x 10-5 mbar
C4.2 - Intermediate chamber 2 to 5 x 10-4 mbar
C4.3 - Intermediate chamber 2 to 5 x 10-3 mbar
C4.4 - Sputter chamber 2 to 5 x 10-3 mbar
C4.5 - Pump chamber 2 to 5 x 10-3 mbar
C4.6 - Sputter chamber 2 to 5 x 10-3 mbar
C4.7 - Intermediate chamber 2 to 5 x 10-3 mbar
C5 - Transfer chamber 2 to 5 x 10-3 mbar
C6 - Buffer chamber 2 to 5 x 10-3 mbar
Leak rate: < 1 x 10-2 mbar l/s-1
Layer thickness / Properties:
AI with copper:
Thickness: 2 μm
Wafer thickness: > 200 μm
Temperature: 400°C / 752°F
Purity: 99.98%
AI with ceramic:
Thickness: 3 μm
Wafer thickness: 150 to 250 μm
Temperature: 300°C / 572°F
Purity: 99.5%
Ag: Thickness: < 300 nm
Sn: Thickness: < 300 nm
NiCr: Thickness: < 40 nm
Uniformity: ± 10%
Evaporation:
Production cycle: 120 h
Power of electron beam
Copper crucible: 100 to 200 kW
Ceramic crucible: 20 kW
Target material per cycle: 90 to 150 kg
Vapor utilization: 48 to 50 %
Target-substrate distance: 600 mm
Carrier frequency: 60s
Sputtering:
Target material: Ag
Target utilization: ~70%
Target life: 240 h
Cooling water:
Particle size: ~50 mg/l
pH Value: (8.0 to 9.0)
Electrical conductivity: (150 to 250) μS/cm
Acid capacity, Ks 4.3: (0.5 to 2.0) mmol/l
Filterable substances: < 50 mg/l
Chloride: < 10 mg/l
Sulfate: < 30 mg/l
Ammonium: < 0.5 mg/l
Nitrate: < 10 mg/l
Colony count (CFU): ~ 1,000 ml-1
TOC (total organic carbon): < 1.5 mg/l
Inlet temperature:
21 to 25°C
69.8 to 77°F
Differential pressure: 2 bar
Absolute pressure max: 8 bar
Water circuit 1 chambers:
Volume flow: TBD m3/h
Temperature: 25°C / 77°F
Required pressure: 6 - 8 bar
Cooling capacity: TBD kW
Electrical system:
3 Phases, 3 AC 480 V
Tolerance: -10/+6 %
Frequency: 59 to 61 Hz
Grounding resistance: <2 Ohm
Connected load max: 400 kVA
Function:
Wafers are coated on one side with (2) metal layers.
VON ARDENNE WM70H/Cは、高品質の薄膜画像やパターンを生成することができる高度なフォトレジスト機器です。このシステムは、幅70 nm、高さ100 nmのサイズを2nmの精度で作成するように設計されています。このユニットは、フォトマスク、リソグラフィーマシン、多数の流動成分、ガスディスペンサー、レジスト源など、いくつかのコンポーネントで構成されています。ウェーハの表面をパターン化するために使用されるフォトマスクは、最初にリソグラフィーマシンにロードされます。その後、流体成分はフォトマスクとウェーハにレジスト(化学混合物)を急速に分配し、均一に広げるのに役立ちます。レジストは洪水源からの光にさらされ、表面の詳細が形成されるテンプレートとして機能するレジストパターンを作成します。ガスディスペンサーは、ガスフローを処理し、エマルジョンの一貫性を保証するために、レジスト表面に保護フッ素膜を正確に適用します。その後、レジストは剥がされ、すすぎ、乾燥され、ウェーハはさらにエッチング処理を受け、レジストを剥がす準備ができています。TheWM70H/Cマシンは、市場で最も先進的なコンポーネントを備えており、優れた画像配置精度、精密パターン定義、および70〜100 nmの半導体リソグラフィープロセス用の高精度フィルム構造を提供します。エッチング後の高調波イメージングツールと組み合わせて使用すると、WM70H/Cは2 nmの精度で、明確で詳細な機能を提供します。さらに、幅広いパラメータと自動化された操作により、セットアップ時間が最小限に抑えられ、生産性が大幅に向上します。高度な半導体プロセスの大量生産環境に最適です。
まだレビューはありません