中古 SPTS Sigma FxP #9058880 を販売中
この商品は既に販売済みのようです。下記の同じようなプロダクトを点検するか、または私達に連絡すれば私達のベテランのチームはあなたのためのそれを見つけます。
タップしてズーム
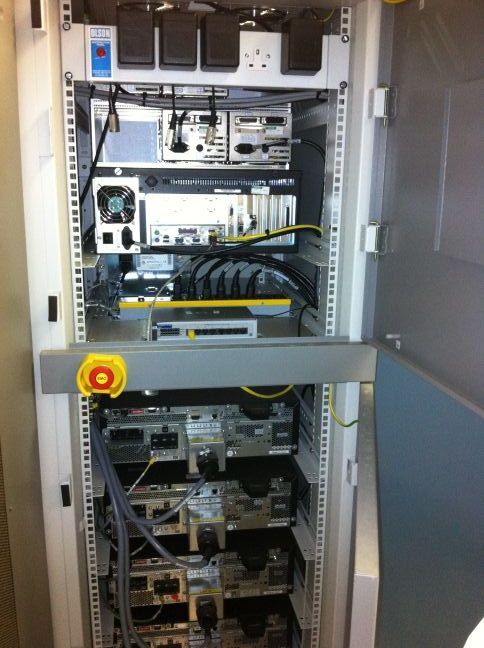

販売された
ID: 9058880
ウェーハサイズ: 6"
PVD System, 6"
Aluminum, Ti, TiN deposition
8-Port Transport Module configured as follows:
• 150 mm wafer size
• Two Vacuum Cassette Elevators (VCE)
• Transfer Chamber with high throughput Magnatran 7B Robot
• Inligner for wafer pre-alignment
• Cooldown Station for post-process wafer cooling
• Pfeiffer TPH260 turbo pump for each VCE
• CTI Onboard 8 Cryo Pump for Transfer Chamber
Hot Soft etch (HSE) module (1):
Inductively Coupled Plasma (ICP) module for wafer heating and/or surface preparation configured with:
• Coil RF driven by AE RFX600A generator
• Platen RF bias driven by AE RFX600A generator
• Phase-locked matching
• High temperature platen
o Resistively heated
o Set temperature range 80 to 600 °C
o PID temperature controller with ±10 °C accuracy
• Gas lines
o 50 sccm MKS MFC for Ar (process)
o 300 sccm MKS MFC for Ar (backfill heat)
• Vacuum system
o CTI Onboard 8F Enhanced Cryo Pump
o MKS 50mT and 10 Torr full range Baratrons
o Inficon BAG100S Ion Gauge
o Two-position gate valve. Process chamber pressure is defined by
gas flows
Standard Aluminium deposition module (2):
DC planar magnetron sputter module for thick aluminium deposition configured with:
• 45 mm fixed target to wafer spacing
• Swept-field magnetron
• AE Pinnacle 30 kW DC Target PSU
• Praxair Al (1%Si) monoblock UFG Target fitted for standard Trikon process acceptance testing
• High temperature standard platen
o Resistively heated
o Set temperature range 50 to 400 °C
o PID temperature controller with ±10 °C accuracy
o Enhanced air cooling for thick film depositions
• Gas lines
o 100 sccm MKS MFC for Ar (process)
• Vacuum system
o CTI Onboard 8F Enhanced Cryo Pump
o MKS 50 mT and 10 T full-range Baratron gauges
o Inficon BAG100S ion gauge
o Two-position gate valve. Gas flows define process pressure.
Standard Aluminium/Ti/TiN/TiW deposition module (1):
DC planar magnetron sputter module for aluminium deposition configured also to deposit titanium, titanium nitride or titanium tungsten.
• 45 mm fixed target to wafer spacing
• Swept-field magnetron
• Slow magnetron motor for Cu-backed target operation
• AE Pinnacle 30 kW DC Target PSU
• Praxair Al (1%Si) monoblock UFG Target fitted for standard Trikon process acceptance testing
• Shutter for in-situ target cleaning
• High temperature standard platen
o Resistively heated
o Set temperature range 50 to 400 °C
o PID temperature controller with ±10 °C accuracy
o Enhanced air cooling for thick film depositions
• Platen RF bias driven by AE RFX600A generator
• Gas lines
o 300 sccm MKS MFC for Ar (process)
o 100 sccm MKS MFC for N2 (process)
• MKS Microvision IP RGA
• Vacuum system
o CTI Onboard 8F Enhanced Cryo Pump
o MKS 50mT and 10 Torr full range Baratrons
o Inficon BAG100S ion gauge
o Two-position gate valve. Gas flows define process pressure.
Cluster tool controller (CTC) and datalogging PC:
• 1 GHz Dual Pentium III with 1 Gb RAM
• 40 Gb SCSI hard drive, 3.5 inch 1.44 Mb floppy, Zip, CD ROM
• TCP/IP comms to Module Controllers
Module controllers:
• PC104-based
• Geode 300MHz with 256 Mb RAM
• Windows embedded OS with Compact Flash storage
Operator interface:
• High resolution colour touchscreen, with membrane keyboard in clean room interface panel
• Maintenance keyboard and touchscreen in grey area. System and module mimic and status displays
• Password access control to user-defined security levels
• High and low-level control of individual devices subject to interlocks and level of security access
Recipe programming:
• Multi-step, multi-chamber recipes possible, with serial, parallel and recursive wafer sequencing
• Recipe entries prompted and checked
Event monitoring:
• Alarms and events displayed and logged
• Light tower displays system status.
• Lot and wafer tracking supported
• Process and machine parameters monitored and displays continuously updated
• Process data logged to disk
Data logging:
• Captures measured values every second
• Stored by wafer number/batch id/process step
• Data displayed on GUI or can be exported to remote PC in .CSV file format for data manipulation
Operating system/software:
• Cluster Tool and Module Controllers run Windows OS
• High-level software in C++
Host computer interface:
• Fully SECS II/GEM compliant via HSMS
The system is CE marked, conforming to the following standards:
• Machine Directive 98/37/EC
• EMC Directive 89/336/EEC
• Low voltage Directive 73/23/EEC
2005 vintage.
SPTS Sigma FxPエッチャー/アッシャーは、低コストのサブプロセスノード製造用に設計された高スループット、高度なエッチングおよびアッシングソリューションです。高解像度イメージング、高スループット処理、リアクティブイオンエッチング(RIE)、原子層蒸着(ALD)機能を1つの統合システムで提供します。このプラットフォームは、今日の大手家電メーカーの高度なパッケージング要件を満たすように設計されています。Sigma FxPの高度なエッチングおよびアッシングソリューションは、薄膜成膜、パターニング、およびウェーハ平面化を含むプロセスに特に有益です。これは、従来の技術よりも小さな左の残留物と少ないプロセス手順で1つのステップで基板に複数の層をエッチングするための使いやすいプラットフォームを提供します。SPTS Sigma FxPは、高度なナビゲーションモジュールとプロセスコントローラ、高度に洗練された統合真空システムを備えています。高精度でリアルタイムなプロセスパラメータの監視と制御により、従来のエッチングまたはアッシングプロセスよりも高い精度を実現します。リアルタイムデータは、プロセスの最適化にも使用できます。Sigma FxPは、リソグラフィープロセスに対応するために、プロセス制御とフィードバックを改善するためのデバイス機能のダイレクトイメージングを可能にします。高度な光学系は、他のほとんどのエッチングおよびアッシングシステムよりも高い分解能を可能にし、より正確な3D微細構造の特性評価を提供することもできます。SPTS Sigma FxPプラットフォームは、処理中のユーザーの介入を減らすための高度な自動化機能も提供します。特許取得済みの2つの精密位置決めシステムにより、プロセスヘッドの再現性と正確な移動が可能になり、アライメント精度が向上し、高精度のロードロックとロードポート操作が可能になり、スループットが向上します。Sigma FxPは、高度な基板処理システムにより柔軟性を高めます。これにより、ユーザーは、損傷やプロセス汚染のリスクなしに、基板を1つの加工ステーションから別の処理ステーションに移動することができます。SPTS Sigma FxPは、ハイスループットと高品質のパフォーマンスを実現するために設計されています。リアルタイムのプロセス監視、制御、最適化を提供し、他の同様のシステムよりも高い収益性を実現します。高度なイメージングとオートメーション機能により、プロセス時間とエネルギー消費の面でコストを削減できます。シグマFxPは信頼性が高く、平均故障時間は20万時間を超えています。これにより、高度なサブプロセスノードプロジェクトのアプリケーションに最適です。
まだレビューはありません