中古 PLASMATHERM 770 ICP #9123970 を販売中
URL がコピーされました!
タップしてズーム


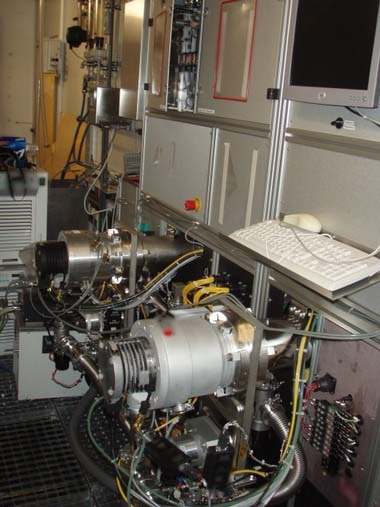



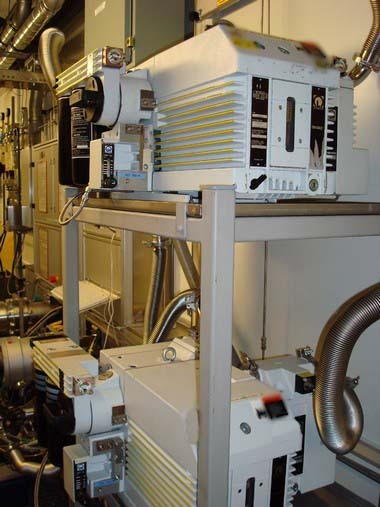

ID: 9123970
ウェーハサイズ: 8"
ヴィンテージ: 1997
Ion coupled plasma etcher system
Dual chamber
Load lock shuttle lock transfer
RFPP–RF5S RF power supply w/AM5
Six zone heater
Pressure controller: PM5
RF20M with phase
Model 919 hot cathode controller
VAT PM5 adaptive pressure controller
Dual pumping stack with Leybold 600C
Leybold D65BCS
Dual sofie endpoint detectors
Gas chemistry:
Non-chlorine side:
(5) MFCs
(1) N2 Purge
Clorine side:
(4) MFCs
(2) N2 Purges
Plasmatherm windows based OS
208V, 3 Phase, 50/60 Hz
1997 vintage.
PLASMATHERM 770 ICPは、もともと半導体産業の開発とプロセス統合のために設計された先進的なドライエッチングエッチャー/アッシャー機器です。特に、高アスペクト比エッチングの課題に対応するよう設計されており、最も困難なプロセスやアプリケーションに適しています。ICP (Inductively Coupled Plasma)源を使用し、イオン化された低種の高密度プラズマを生成し、代替エッチングシステムよりも高い精度と均一性を実現します。ICPは10.2MHzで動作し、最大400ワットの電力範囲を持ち、電力とエッチング深さを正確に制御できます。ICPはまた、450〜950°Cの温度で動作し、柔軟性と精度を高めるために0〜1000 mTorrの圧力範囲を持っています。また、Energy Neutral Charged Particles (Energy Neutral Charged Particles、 ENCP)ソースも備えており、ウェーハの長期的な損傷を軽減するように設計されています。このソースはイオン化された粒子を排除し、より均一なエッチング処理を行い、微細な特徴に対する損傷を軽減し、全体的な精度を向上させます。ENCPは、代替エッチング技術と比較して、エッチング速度が高く、面粗さが低下することもあります。また、モーションとオプトメカニカルオートセンタリングの3軸を搭載し、生産性と精度を向上させています。5。8インチプロセスチャンバーを使用すると、770 ICPはあらゆるサイズのウェーハにフィットし、直径8。0インチまでのエッチングプロセスを実行できます。セラミックライニングプロセスチャンバーは、安定したエッチング環境を作り出す均一な温度設計も特徴です。高度なプロセス制御のために、このツールは、熱制御、プロセスレシピマネージャ、半自動ウェハ転送などの高度なオートメーション機能を利用しています。完全に自動化されたロボティックガス資産は、オペレータの介入を減らし、生産性を向上させるだけでなく、ガス混合物のより大きな制御のための追跡可能なガス供給モデルも利用できます。全体として、PLASMATHERM 770 ICPエッチャー/アッシャー装置は、半導体業界で最も困難なプロセスとアプリケーション向けに設計された強力で信頼性の高いツールです。高密度プラズマ、均一な配電、自動ガスシステムにより、エッチング精度と再現性に優れています。
まだレビューはありません



