中古 OXFORD Plasmalab 100 #9410020 を販売中
URL がコピーされました!
タップしてズーム


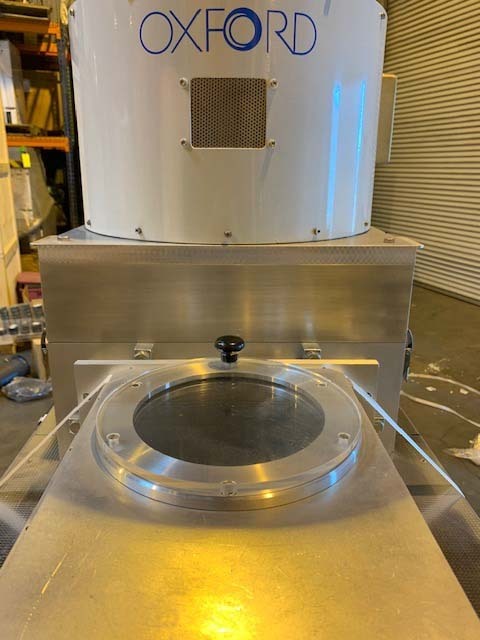









ID: 9410020
ウェーハサイズ: 3"-8"
ヴィンテージ: 2000
ICP Reactive Ion Etcher (RIE), 3"-8"
Chamber
Low temperature silicon etching system
Unique process gases:
Hexafluoroethane (C2F6)
Octafluorocyclobutane (C4F8)
Trifluoromethane (CHF3)
Hydrogen
Anisotropic etching system:
Silicon
Silicon oxide
Silicon nitride
Electrode temperature range: -150 °C to 300 °C
Power source: Up to 600 W at 13.56 MHz
Radio Frequency (RF) Power source: Up to 600 W at 13.56 MHz
2000 vintage.
OXFORD Plasmalab 100は精密および表面のエッチングのために、また精密なサンプル準備のために設計されている最先端のエッチャーおよびasherシステムです。高度なプラズマ表面改質やナノスケール処理に最適です。このデバイスは、より高い温度、より高いアスペクト比、低い抵抗、およびより高いパワーエッチングプロセスで優れた性能を提供します。プラズマラブ100は、プラズマプロセッサとチャンバーの2つのコンポーネントで構成されています。プラズマプロセッサは、電源、ガス配電システム、エッチングチャンバー、および監視用の2つのビューポートで構成されています。この電源は、エッチングチャンバーに最大55kWの電力を出力し、デジタル温度制御とガスの流れと圧力の直接制御を備えているため、プロセスの正確な調整とメンテナンスが可能です。チャンバーには、調整可能なバイアスを備えた480mm x 480mmの静電チャックが取り付けられています。チャックの面は、必要なときに異なる角度に調整することもできます。高精度リニアアクチュエータにより高精度な高さと角度調整が可能です。ガス分配システムは、最大4つの独立したバルブと4つの独立したガス供給ラインで構成されており、チャンバー内の圧力と組成を正確に制御できます。バルブは自動化されているため、プロセス条件を変化させるために正確に制御することができます。エッチングチャンバーはステンレス鋼とパッシブ酸化ケイ素から構成されており、高い清浄度と低接着面を維持するのに最適です。チャンバーは温度制御されており、主に放射からユーザーを保護するための内部アーキテクチャを備えています。また、圧力を制御するための圧力制御バルブが装備されています。OXFORD Plasmalab 100は、幅広い材料の高精度エッチングと表面改質のために設計されています。特に、微小歯車やナノワイヤなどの小型部品のナノ製造、ナノデバイスやMEMSなどの複雑なデバイスに適しています。フォトレジストエッチング、RIE/ICPエッチング、その他の加工にも使用できます。このシステムは非常に柔軟で構成可能で、幅広いタイプのガス、固定、オートメーションオプションがあります。セットアップ、操作、メンテナンスが簡単です。
まだレビューはありません