中古 THERMCO TMX 9000 #173055 を販売中
この商品は既に販売済みのようです。下記の同じようなプロダクトを点検するか、または私達に連絡すれば私達のベテランのチームはあなたのためのそれを見つけます。
タップしてズーム
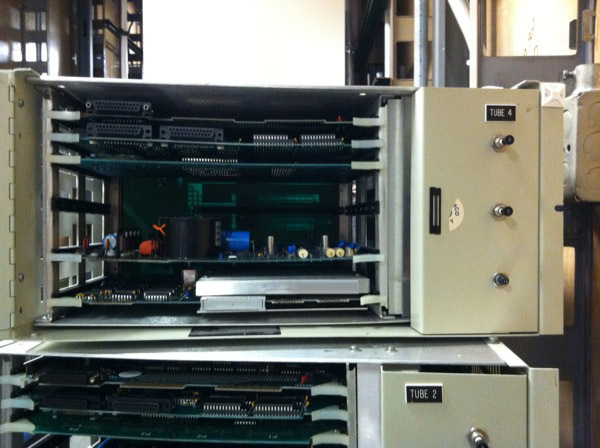

販売された
ID: 173055
ウェーハサイズ: 4"
Furnaces, 4"
4-stack
A1, Sintering
A1: Post CMOS
Tool specifications: 4" substrates only 25 substrates
Tool Overview
Annealing, in metallurgy and materials science, is a heat treatment wherein a material is altered, causing changes in its properties such as strength and hardness
It is a process that produces conditions by heating and maintaining a suitable temperature, and then cooling.
Annealing is used to induce softness, relieve internal stresses, refine the structure and improve cold working properties.
The tool consists of a quartz process tube, surrounded by heating coils with three zone spike/profile temperature control, gas injection system, load and unload station, and MUX computer and tube control computers
Tool Capabilities:
• Sintering (annealing) Metals
• Hydrogen drive-in gas
• Post CMOS Tube
• Configured for 4” wafers
• Can process any number of wafers from 1 to 25 at a time
• Allowed Metals: aluminum, nickel, tantalum, chrome, iridium, molybdenum, tungsten and titanium
• Metals Not Allowed: Gold, copper, lead, tin, and platinum
• Organics (example polyimide) are never allowed in this tube.
• You cannot go into any other furnace tube except C2 after you have been in A1
A2, Boron-dope (deposition)
A2-4: CMOS only No metals, glass substrates, III-V material, and no wafers that have previously been in SG RIE/right chamber Plasma Therm/”Dirty” oven. 24 substrate one side doped/11 substrates both sides doped.
Tool Overview
Diffusion is the spontaneous net movement of particles from an area of high concentration to an area of low concentration
Diffusing molecules will move randomly between areas of high and low concentration but because there are more molecules in the high concentration region, more molecules will leave the high concentration region than the low concentration one.
Therefore, there will be a net movement of molecules from high to low concentration.
Initially, a concentration gradient leaves a smooth decrease in concentration from high to low which will form between the two regions.
As time progresses, the gradient will grow increasingly shallow until the concentrations are equalized.
The tool consists of a quartz process tube, surrounded by heating coils with three zone spike/profile temperature control, gas injection system, load and unload station, and MUX computer and tube control computers.
Tool Capabilities
• Boron Diffusion
• 12 BoronPlus Solid Dopant Sources
• Configured for 4” wafers
• Can process any number of wafers from 1 to 25 at a time
• CMOS compatible tube
• No metals, glass substrates or III/V materials
• No wafers previously in “dirty” ovens
• No wafers from A1, B3 or C2
• Wafers from A2 may only go directly into A4
• There must be at least 13 wafers in this tube at all times
A3 was not in use
A4, Boron ANL/Oxide (boron drive in)
A2-4: CMOS only No metals, glass substrates, III-V material, and no wafers that have previously been in SG RIE/right chamber Plasma Therm/”Dirty” oven
Tool specifications: 4" substrates only. 25 substrates
Process Gas:H2/O2/N2
Tool Overview
After the initial Boron Doping, there will typically be a high concentration impurity profile at the wafer surface.
The Drive-In process is used to more evenly distribute the dopant throughout
the silicon.
This tube also has wet and dry oxidation capabilities.
The tool consists of a quartz process tube, surrounded by heating coils with three zone spike/profile temperature control, gas injection system, load and unload station, and MUX computer and tube control computers.
Tool Capabilities
• Boron Drive-In
• Wet and Dry Oxide
• Configured for 4” wafers
• Can process any number of wafers from 1 to 25 at a time
• CMOS compatible tube
• No metals, glass substrates or III/V materials
• No wafers previously in “dirty” ovens
• Wafers from A4 may not go into any other furnace tube unless you first strip the BSG and perform a PFC
• Wafers from A4 may not go into a PFC box
B1, used for clean storage.
B2, TCA-Oxidation
Max run time for wet Oxide is 11 hours.
All tubes are CMOS compatible
No metals, glass substrates, III-V material, and no wafers that have previously been in SG RIE/right chamber Plasma Therm/”Dirty” oven
Tool specifications: 4" substrates only
B1 is used for storage 7 boats/25 substrates each 72 hour time limit
B2 is used for wet and dry thermal oxide (field oxide) 25 substrates
Chemical vapor deposition (CVD) is a chemical process used to produce high-purity, high-performance solid materials.
The process is often used in the semiconductor industry to produce thin films. In a typical CVD process, the wafer (substrate) is exposed to one or more volatile precursors, which react and/or decompose on the substrate surface to produce the desired deposit.
Frequently, volatile byproducts are also produced, which are removed by gas flow through the reaction chamber.
The tool consists of a quartz process tube, surrounded by heating coils with three zone spike/profile temperature control, gas injection system, load and unload station, and MUX computer and tube control computers.
Tool Capabilities
• Wet and dry thermal oxide (field oxide), TCA oxide
• Configured for 4” wafers
• Can process any number of wafers from 1 to 25 at a time
• CMOS compatible tube
• No metals, glass substrates or III/V materials
• No wafers previously processed in right chamber Plasma-Therm
• No wafers previously in “dirty” ovens
B3, Phos-dope
All tubes are CMOS compatible
No metals, glass substrates, III-V material, and no wafers that have previously been in SG RIE/right chamber Plasma Therm/”Dirty” oven
Tool specifications: 4" substrates B3 is used for phosphorous doping 25 substrates
In semiconductor production, doping refers to the process of intentionally introducing impurities into an extremely pure (also referred to as intrinsic) semiconductor in order to change its electrical properties.
The impurities are dependent upon the type of semiconductor.
Lightly and moderately doped semiconductors are referred to as extrinsic.
A semiconductor which is doped to such high levels that it acts more like a conductor than a semiconductor is called degenerate.
The tool consists of a quartz process tube, surrounded by heating coils with three zone spike/profile temperature control, gas injection system, load and unload station, and MUX computer and tube control computers.
Tool Capabilities
• Phosphorous doping
• Configured for 4” wafers
• Can process any number of wafers from 1 to 25 at a time
• CMOS compatible tube
• No metals, glass substrates or III/V materials
• No wafers previously processed in right chamber Plasma-Therm
• No wafers previously in “dirty” ovens
B4 Phos ANL/Oxide
All tubes are CMOS compatible
No metals, glass substrates, III-V material, and no wafers that have previously been in SG RIE/right chamber Plasma Therm/”Dirty” oven
Tool specifications: 4" substrates only
B1 is used for storage 7 boats/25 substrates each 72 hour time limit
B2 is used for wet and dry thermal oxide (field oxide) 25 substrates
B3 is used for phosphorous doping 25 substrates
B4 is used for phosphorous drive in and thermal oxide 25 substrates Process Gas:H2/O2/POCl
After the initial Phosphorous Doping, there will typically be a high concentration impurity profile at the wafer surface.
The Drive-In process is used to more evenly distribute the dopant throughout the silicon.
This tube also has wet and dry oxidation capabilities.
The tool consists of a quartz process tube, surrounded by heating coils with three zone spike/profile temperature control, gas injection system, load and unload station, and MUX computer and tube control computers.
Tool Capabilities
• Phosphorous Drive-In
• Wet and Dry Oxide
• N2 Anneal
• Configured for 4” wafers
• Can process any number of wafers from 1 to 25 at a time
• CMOS compatible tube
• No metals, glass substrates or III/V materials
• No wafers previously processed in right chamber Plasma-Therm
• No wafers previously in “dirty” oven
(1) Computer stack available
Advanced Crystal Sciences cantilever boat loader controller (1998 vintage)
Available: tube and mux computers, the gas boards from the side doors of the gas shelf, UPS, hard drive and tape backup, 3 tubes were LPCVD tubes
Thermocouples not included
Currently stored in a cleanroom.
THERMCO TMX 9000拡散炉とその付属品は、高性能の炉の品質設計および構築されたラインです。TMX 9000は、シングルウェーハ拡散、低温拡散、ポリシリコンドーピングなど、さまざまな用途に最適です。また、反復操作にも適しており、急速加熱、優れた温度均一性、比類のないプロセス安定性により際立っています。THERMCO TMX 9000は、基地局、加熱ゾーン、真空チャンバーで構成されています。ガスアシストで、USFD (Uniformity Spread Function)を簡単に変更できます。USFDは± 2°から± 4°に調節することができ温度および期間の精密な制御を可能にします。また、USFDは、密接な温度制御、熱および窒素アシスト機能、および新しい制御コーディングの組み合わせにより、ウェハスタック全体の中心または上下に均一性を変化させることができます。TMX 9000には、高度なオーブンコントローラと冷却システムが装備されており、急速な加熱および冷却時間、および精密でエネルギー効率の高い動作を可能にします。ロードロックアセンブリは、迅速かつ効果的なローディングとアンロード機能を提供します。プログラム可能なCDG (Clustered Degassed Gas)システムには、独自のCDGフローパターンが含まれており、拡散プロセス中の優れたウェーハの均一性を提供します。THERMCO TMX 9000を使用すると、さまざまな制御パラメータと設定を確立し、パラメータが一貫していることを確認して一貫した結果を得ることができます。TMX 9000は、拡散およびドーピングプロセスのための貴重なツールであり、ユーザーに驚くべき精度、プロセスの複雑さ、および動作安定性を提供します。これらのすべての側面は、優れた信頼性の高いプロセスを提供するために一緒に来る。CDGフローパターン技術と相まって、優れた均一性と温度制御により、THERMCO TMX 9000は、あらゆるラボでの拡散およびドーピングプロセスに必要不可欠です。
まだレビューはありません