中古 ESEC 3088iP #9091720 を販売中
URL がコピーされました!
タップしてズーム
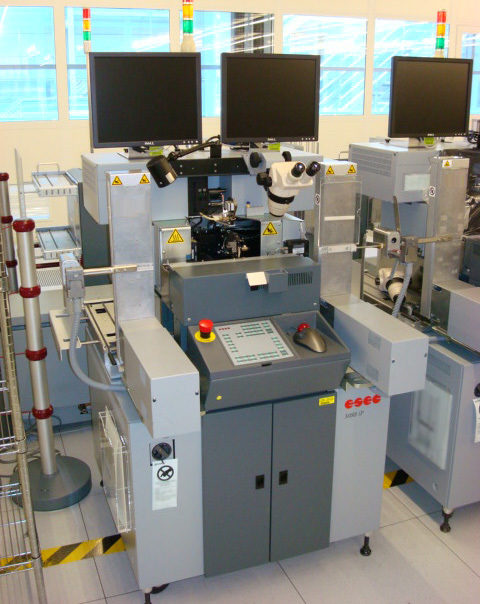

ID: 9091720
ヴィンテージ: 2002
Wire bonder
Flying bondhead:
Bond placement accuracy: ± 3.5 μm (3 Sigma)
Typical sprint UPH: (11) Wires / Second
Max. bonding area: 52 x 64mm / 2 x 2.5"
Indexer:
Process zone temperature: 50 to 300°C
Pre-bond / post-bond zone: 50 to 300°C
Process heater adapter blocks standard widths: 8/24/44 mm 0.31/0.95/1.73"
Pre / post-bond heater plates standard widths: 8/25/45/69 mm 0.31/0.98/1.77/2.72"
Wire:
Spool diameter: 50.8 mm / 2"
Spool width: 25.4 to 50.8 mm / 1 to 2"
Windings: single or multi layer
Gold wire diameter:
Standard: 17.5 to 50 μm / 0.7 to 2.0 mils
Capillary:
Length: 11.1 mm / 0.437"
Diameter 1.58 mm / 1/16"
PRS System:
Chip alignment:
Std. mode: 10 ms
Adv. mode: 30 ms
Leadframe alignment single mode: 10 ms
Finger alignment: ≤ 6 ms/ finger (304 ld)
Looping:
Flat loop: 125 to 250 μm < 8 μm, 5 to 10 mils < 0.3 mils
Standard loop: 125 to 200 μm < 8 μm, 5 to 8 mils < 0.3 mils
Typical data TSOP:
Wire length: 2 - 3 mm (140 μm 6 μm)
Typical data QFP:
Wire length: 3 - 4 mm (200 μm 8 μm)
Max. wire length: 7 mm / 280 mils
Wire straightness: < 1% of wire length
Magazine handling:
Magazine gripper with self-adjusting clamps
Buffer capacity magazine platform:
(4) Magazines for QFP 84 L/F
Loading / Unloading platform dimensions:
Depth: 227mm / 8.93"
Width (adjustable): 120mm / 4.72" to 260mm / 10.23"
2002 vintage.
ESEC 3088iPは、半導体チップの個々のピンとリードの間に密接な電気接続を形成するように設計された産業用半導体包装機です。このマシンは、高精度の半導体パッケージのハイスループット製造を可能にするために、高度なウェッジおよびバーボンダー技術を使用しています。ESEC 3088I Pパッケージは、タッチスクリーンデジタルインターフェース、超音波ボンダーヘッド、アライメントシステム、パラメーター制御ユニット、ボンドデータ制御ユニットなど、いくつかの主要コンポーネントで構成されています。デジタルインターフェイスは、プロセスパラメータの選択と表示とともに、簡単で直感的な機械制御を可能にします。超音波ボンダーヘッドは、幅広いパッケージサイズとリード長を扱うことができる二軸システムで構成されています。アライメントシステムは、顕微鏡、CCDラインスキャンカメラ、翻訳マイクロメーターヘッドで構成されています。この部品の組み合わせは、プリント基板とチップのリード間のアライメントを測定し、正確なボンド配置を保証することができます。パラメータ制御ユニットは、周波数、電力、フラックス、ウェッジ力、電極ブレード圧力、ボンド力など、ボンドプロセスのさまざまな特性を制御するために使用されます。ボンドデータ制御ユニットは、品質保証およびトレーサビリティ目的でボンドデータを保存および監視するために使用されます。3088 IPユニットは、自動化された製造プロセスに迅速かつ便利なボンディングソリューションを提供します。このマシンは高いスループットレートを持ち、マルチチップモジュール(MCM)、クアッドフラットノンリードパッケージ(QFN)、スモールアウトライン集積回路(SOIC)、チップスケールパッケージ(CSP)など、さまざまな半導体パッケージに対応できます。また、自動電源および温度管理、高度なフラックス制御、パルス振動、多点力制御などの高度な機能も備えています。機械の全面的な設計は結合プロセスの間にパッケージか鉛を傷つける危険を非常に減らします。さらに、このマシンが生成する高品質の結果は、エラーのない動作を可能にし、ユーザーに最高の精度と信頼性でボンド操作が実行されるという信頼性のレベルを作成します。
まだレビューはありません